Как известно, акустоэлектронные устройства, работающие в диапазоне частот от 1,5 ГГц до 15 ГГц, можно создать на основе тонкопленочных пьезокристаллических структур из нитрида алюминия AlN, нитрида галлия GaN [1]. Специфической трудностью выращивания эпитаксиальных слоев AlN, GaN является отсутствие промышленной технологии получения больших (>1см) монокристаллов AlN, GaN, пригодных для изготовления подложек для гомоэпитаксии. Поэтому вплоть до настоящего времени, практически вынужденным является гетероэпитаксиальное выращивание пленок AlN, GaN на инородных подложках.
Существует целый ряд технологий, позволяющих выращивать гетероэпитаксиальные тонкопленочные структуры [2]. К таким технологиям относятся: молекулярно-лучевая эпитаксия (МЛЭ), газофазная эпитаксия, химическое осаждение из паровой фазы с использованием металлорганических соединений в низком вакууме или атмосферном давлении (MOCVD-технология), импульсное лазерное напыление (ИЛН), ионно-плазменное напыление (ИПН) в среднем вакууме (в том числе и метод магнетронного реактивного радиочастотного распыления (ММРРР).
Положительные результаты эпитаксиального выращивания пленок AlN, GaN были получены методом реактивного магнетронного радиочастотного распыления, где температура (Т) роста пленок была понижена до 500˚С [3] в отличии от MOCVD-технологии (Т~1200˚С). Тем не менее, в эпитаксиальных слоях AlN, GaN, полученных ММРРР-технологией, основной причиной больших акустических потерь при распространении акустической волны является шероховатость поверхности и дефектность слоев.
Одним из наиболее качественных технологий гетероэпитаксиального выращивания тонкопленочных ориентированных структур является молекулярно-лучевая эпитаксия МЛЭ, позволяющая выращивать тонкопленочные монокристаллические структуры с атомарно-гладкой поверхностью, которая и была выбрана в данной работе.
Для качественного гетероэпитаксиального роста слоев азотосодержащих соединений (AlN, GaN) существует проблема выбора подложек. В качестве основного критерия для такого выбора рассматривается соответствие кристаллических решеток материалов подложки и выращиваемого слоя. Под этим подразумевается соответствие кристаллических решеток слоя и подложки, а также их термических коэффициентов линейного расширения. Из-за рассогласования решеток подложки и слоя гетероэпитаксиальные слои AlN, GaN бывают сильно напряжены (вплоть до растрескивания), имеют, как правило, мозаичную структуру и содержат высокую плотность структурных дефектов, таких как домены и малоугловые границы, дислокации и точечные дефекты. Другим не менее важным критерием является требование химической и термической стабильности подложки к среде эпитаксиального роста при температуре эпитаксии.
С учетом указанных требований наиболее распространенным материалом подложек для роста монокристаллических слоев AlN, GaN в настоящее время являются сапфир Al2O3 и кремний Si. Кроме высокой термической и химической стабильности при высоких температурах роста, они обладают прекрасной структурной и поверхностной морфологией и возможностью их получения в промышленных масштабах.
В работе изложены результаты экспериментальных измерений кристаллографических свойств и морфологии поверхности гетероэпитаксиальных ориентированных тонкопленочных пьезоструктур нитрида алюминия AlN, нитрида галлия GaN, выращенных методом молекулярно-лучевой эпитаксии.
Результаты измерений кристаллографических свойств и морфологии поверхности гетероэпитаксиальных тонкопленочных структур AlN/Al2O3 и GaN/Al2O3
Выращивание гетероэпитаксиальных слоев нитрида алюминия AlN и нитрида галлия GaN на сапфировой подложке Al2O3 с-среза было осуществлено методом молекулярно-лучевой эпитаксии, позволяющим выращивать тонкопленочные структуры с атомарно-гладкой поверхностью и наиболее низкой дефектностью слоев. Тестовые слои на основе AlN (GaN) были выращены на подложках сапфира (0001) на отечественных установках серии ЭПН (SemiTEqTM, ЗАО «Светлана-Рост»), специализированных для молекулярно-лучевой эпитаксии (МЛЭ) нитридов III группы с использованием аммиака в качестве источника азота.
Метод молекулярно-лучевой эпитаксии в сверхвысоком вакууме реализуется в сверхвысоковакуумных установках, откачиваемых до давления остаточных газов ~ 10-10-10-9 мм. рт. ст., что обеспечивает уникальные условия для эпитаксиального роста пленок. С физической точки зрения эпитаксиальный рост является фазовым переходом первого рода. Различают четыре стадии образования пленки на подложке: возникновение зародышей, рост зародышей, миграция и срастание зародышей, эпитаксиальный рост сплошной пленки [2]. Методом МЛЭ были выращены тонкопленочные структуры нитрида алюминия и нитрида галлия толщиной 0,2 мкм и 2 мкм на сапфировой подложке с-среза толщиной 0,5 мм.
В качестве основного метода диагностики кристаллографических свойств гетероэпитаксиальных структур был выбран метод рентгеновской дифрактометрии (РД) на базе дифрактометра рентгеновского общего назначения (ДРОН-4, CuKa1-излучение). Техника РД обладает широкими возможностям неразрушающего контроля многослойных эпитаксиальных структур [4-8]. К достоинствам метода относятся: простота реализации, неразрушающий характер анализа по глубине и высокая информативность.

Рис.1. Рентгеновская кривая качания слоя AlN (h=0.2мкм) на сапфире Al2O3
На Рис. 1 показана экспериментально измеренная дифрактограмма пленки AlN толщиной h=0,2 мкм на сапфировой подложке Al2O3 с-среза, выращенной методом молекулярно-лучевой эпитаксии. По данным рентгеновской дифрактометрии (ДРОН-4, CuKα1-излучение) подложка идентифицирована как сапфир с-среза, поскольку дает отражение на угле 2θ=41,7о в симметричном положении. Это совпадает с положением пика α-Al2O3 (0006). Кроме отражения от подложки есть отражение от слоя на угле 2θ=36,05о в симметричном положении с шириной по кривой качания FWHM ω=0,05о. Слой идентифицирован как эпитаксиальный AlNhex, вычисленное положение пика (0002) 2θ=36,03о, что соответствует ориентации пленки нитрида алюминия в индексах Миллера (0002), т. е. с-ось направлена перпендикулярно поверхности пленки.
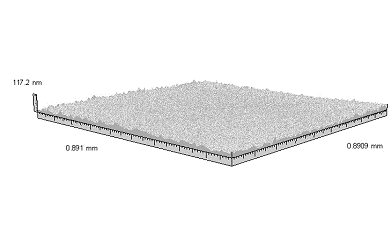
Рис. 2. Морфология поверхности пленки AlN (h=0,2мкм)
В акустоэлектронике предьявляются достаточно высокие требования к поверхности пьезозвукопровода, поскольку дефекты поверхности могут сильно влиять на потери распространения акустической волны. На Рис. 2 показан экспериментально измеренный вид морфологии поверхности пленки AlN, полученный на интерференционном микроскопе Talysurf CCI 2000. На Рис. 3 показан также вид профиля поверхности пленки. Как видно из Рис. 3, шероховатость поверхности пленки составляет Sq = ±3 нм. Общая среднеквадратичная шероховатость в полном кадре 0,9 х 0,9 мм2 составляет Sq=18 нм, т. к. дефекты занимают малую площадь, поэтому данная структура вполне подходит в качестве звукопровода, имеющего малые акустические потери.

Рис. 3. Вид профиля поверхности пленки AlN (h=0.2мкм)
На Рис. 4 показана экспериментально измеренная дифрактограмма пленки AlN толщиной h=2мкм, выращенной на сапфировой подложке Al2O3 c-среза. Ширина пика по кривой качания FWHM ω=0,12о. Слой идентифицирован как эпитаксиальный монокристаллический AlNhex, вычисленное положение пика (0002) 2θ=36,03о.

Рис. 4. Рентгеновская кривая качания слоя AlN (h=2мкм) на сапфире Al2O3

Рис. 5. Шероховатость поверхности пленки AlN (h=2мкм)

Рис. 6. Рентгеновская кривая качания слоя GaN (h=2мкм) на сапфире Al2O3
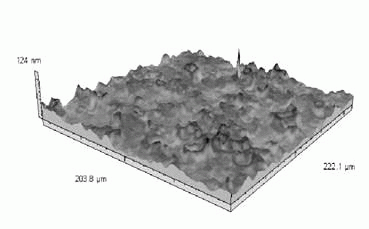
Рис. 7. Морфология поверхности пленки GaN
На Рис. 7 показан экспериментально измеренная морфология поверхности слоя GaN (h=2мкм), полученный на интерференционном микроскопе Talysurf CCI 2000. Общая среднеквадратичная шероховатость в полном кадре 0,9 х 0,9 мм2 Sq=11 нм, что говорит о хорошем качестве атомарно-гладкой поверхности слоя GaN.
Заключение
Таким образом, результаты рентгеноструктурного анализа и оптической профилометрии показали, что слои нитрида алюминия и нитрида галлия, выращенные на сапфире методом МЛЭ, имеют монокристаллическую гексагональную структуру с-среза (0002). Кроме этого, морфология слоев имеет атомарно-гладкую поверхность. Общая среднеквадратичная шероховатость поверхности порядка Sq ~3-18 нм.
Данные обстоятельства являются необходимыми и достаточными для использования данных тонкопленочных структур в качестве пьезозвукопровода и возбуждения в нем электроакустических поверхностных волн различного типа.
В заключении авторы выражают свою благодарность экспериментальной группе из ЗАО «Светлана-Рост» (г. Санкт-Петербург) за помощь в выращивании рассмотренных гетероструктур методом МЛЭ, а также Дроздову Ю.Н. (ИФМ РАН, г. Н. Новгород) за проведение рентгеноструктурного анализа выращенных структур.
Список литературы
- Мэзон У., Терстон Р., Физическая акустика. Принципы и методы. - М.: Мир. 1973. С. 432.
- Молекулярно-лучевая эпитаксия и гетероструктуры. Перевод с английского под редакцией акад. Ж.И. Алферова и д-ра физ.-мат. наук проф. Ю.В. Шмарцева, - М.: Мир. 1989. - С. 589.
- Kaya K., Shibata Y. and etc. // Jpn.J. Appl. Phys., 36, 1997, p. 2837.
- Ратников В.В., Кютт Р.Н., Шубина Т.В. // ФТТ. 2000. Т. 42. С. 2140.
- Sricant V., Speck J.S., Clarke D.R. // J. Appl. Phys. 1997. V. 82. P. 4286.
- Angeler H., Brunner D., Freudenberg F. et all. // Appl. Phys. Lett. 1997. V. 71. P. 1504.
- Zhou S., Wu M., Yao S. // Chin. Phys. Lett. 2005. V. 22. P. 3189.
- Moram M.A., Wickers M. E. // Rep. Prog. Phys. 2009. V. 72. P. 036502.
Библиографическая ссылка
Двоешерстов М.Ю., Чередник В.И., Беляев А.В., Денисова А.В., Сидорин А.П. ГЕТЕРОЭПИТАКСИАЛЬНЫЕ СТРУКТУРЫ AlN/Al2O3 И GaN/Al2O3 ДЛЯ АКУСТОЭЛЕКТРОННЫХ СВЧ УСТРОЙСТВ // Современные наукоемкие технологии. 2010. № 9. С. 24-30;URL: https://top-technologies.ru/ru/article/view?id=25334 (дата обращения: 22.04.2026).



